
文章圖片

文章圖片
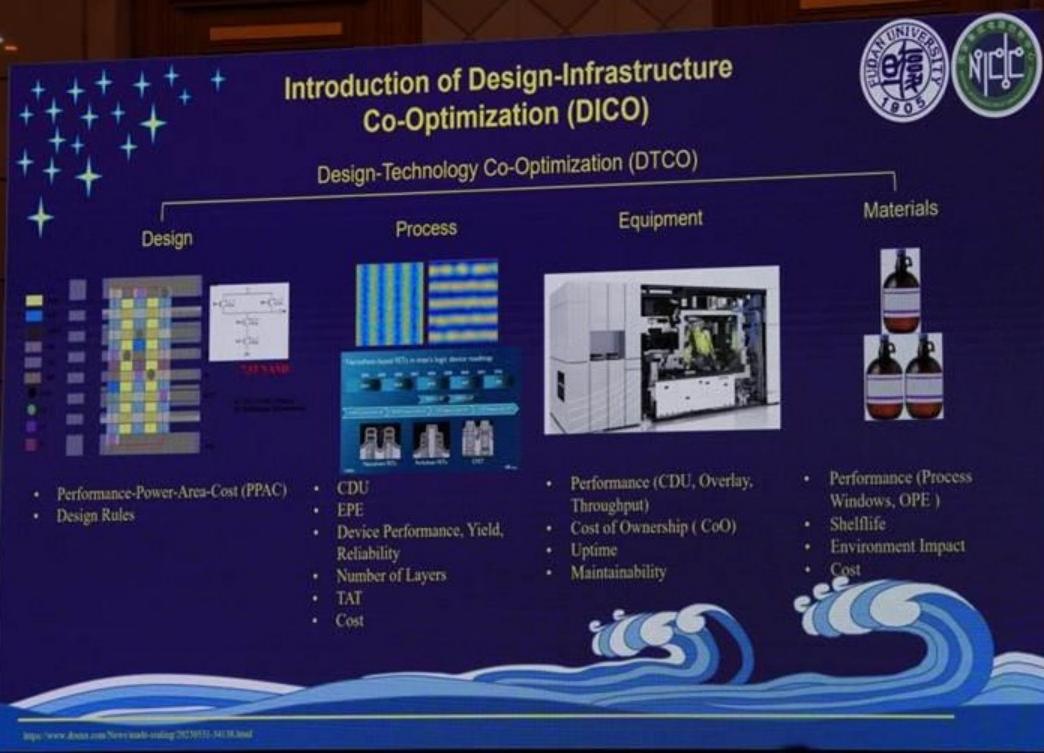
文章圖片

文章圖片
在半導體產業的“微縮競賽” 中 , 光刻技術始終是決定芯片性能天花板的關鍵 。 從微米級工藝到納米級突破 , 從深紫外(DUV)到極紫外(EUV)的技術迭代 , 它不僅承載著摩爾定律演進的核心動力 , 更成為全球科技競爭與產業協同的戰略焦點 。 如今 , 隨著芯片應用向人工智能、新能源汽車、量子計算等領域延伸 , 市場對更高集成度、更低功耗芯片的需求愈發迫切 , 而光刻技術面臨的物理極限挑戰、工藝復雜度提升、全產業鏈協同難題也隨之加劇 , 一場跨越國界、連接產學研的技術對話 , 成為推動行業突破的必要支撐 。
歷經八屆沉淀 , 國際先進光刻技術研討會(IWAPS)已成長為覆蓋光刻設備、工藝制程、計量檢測、掩模材料、計算光刻、系統協同優化及新型技術等全產業鏈交流樞紐 , 累計吸引數千名國內外科研機構專家、高校學者、企業領軍者參與 , 成為推動全球光刻技術交流與創新的重要力量 。
2025年10月14-15日 , 這場光刻領域的年度盛會將迎來新的里程碑——第九屆國際先進光刻技術研討會(IWAPS)在深圳隆重啟幕 。 本屆國際先進光刻技術研討會(IWAPS)由中國集成電路創新聯盟和中國光學學會主辦 , 中國科學院微電子研究所、深圳市半導體與集成電路產業聯盟和南京誠芯集成電路技術研究院有限公司承辦 , 國際光學工程學會(SPIE)技術支持 , 中國科學院大學集成電路學院、中國光學學會光刻技術專業委員會協辦 。
IWAPS會議主席、中國集成電路創新聯盟理事長曹健林 , IWAPS會議主席、中國集成電路創新聯盟副理事長兼秘書長、中國科學院微電子研究所研究員葉甜春 , 中國光學學會會士、IEEE會士、美國光學學會會士、SPIE會士、IEEE光子學協會全球主席沈平 , 深芯盟相關領導等出席開幕式并講話 。 開幕式由中國科學院大學教授、中國科學院微電子研究所研究員、SPIE會士、中國光學學會會士韋亞一主持 。
IWAPS會議主席、中國集成電路創新聯盟理事長曹健林表示 , 當前光刻技術正呈現出多元化突破態勢 , 極紫外光刻持續向高數值孔徑邁進 , 新一代光刻膠材料也在持續推動技術變革發展 。 這些技術進步共同描繪了后摩爾時代集成電路發展嶄新藍圖 。 九年來 , 我們既深耕自主創新 , 也擁抱全球協作 。 我們深知 , 光刻技術的復雜性決定了它必須依靠全球智慧和協同努力才能持續進步 。 因此 , 我們堅持自立自強與開放合作并步齊驅 , 在夯實本土研發根基的同時 , 更積極地融入全球創新網絡 。 我們欣喜地看到 , 中國力量正不斷為全球光刻產業注入新的活力 。 同時我們也堅信 , 人才是光刻技術發展的根本動力 。
接著 , 曹健林分享了三點感受:
第一 , 光陰似箭 , 唐朝名士孟浩然曾說“人事有代謝 , 往來成古今” 。 曹健林回顧個人經歷 , 40年前導師王大珩先生為其選擇了與極紫外光刻(EUV)相關的專業 , 并送其到日本研究為EUV服務的高反射膜 , 完成博士學業 。 40年后的今天 , 光刻技術精度從微米級發展到亞納米級 , 也從小眾走向大眾 , 今天中國人都知道光刻 , 乃至EUV光刻 。
第二 , 一個學科的發展需要強大的經濟基礎和產業基礎 , 中國已經在全球微電子產業和先進制造產業方面具備良好基礎 , 為光刻技術發展提供了支撐 。
第三 , 學會的組織形式要跟上時代 , 學會的組織活動應嚴格按照規程推進 , 以保證其在學術界、產業界和科技界的引領性 。 十分期待IWAPS的未來發展 , 希望大會能夠第十屆、第二十屆、第三十屆的持續辦下去 。
IWAPS會議主席、中國集成電路創新聯盟副理事長兼秘書長、中國科學院微電子研究所研究員葉甜春表示 , 到了2025年 , 全球科技快速迭代 , EUV 進入量產 , 高數值孔徑的EUV開始逐步進入市場工藝驗證階段 , 集成電路尺寸進入納米級 。 以尺寸縮微為驅動力的摩爾定律延展逼近物理和經濟極限 , 光刻技術面臨的挑戰愈發復雜 。 光刻技術進入融合創新階段 , 人工智能和機器學習深度融入光刻工藝 , 包括工藝建模、矯正優化和全流程優化 , 提高圖形保真度和開發效率 。 新興材料、3D 集成和異質異構整合技術不斷擴展光刻技術的應用邊界 。 而未來量產的二維材料等非傳統器件的創新需求 , 對下一代圖形化技術提出全新課題 。 中國作為全球產業鏈重要板塊 , 正成為全球創新的高地 , 在光刻及圖形化技術各方面取得積極進步 , 如光刻膠、掩模制造、計算光刻軟件相關的各種工藝融合等 。 他還表示 , 中國堅定走全球化之路 , 堅持深化國際合作、開放合作、協同創新的理念 , 共同維護全球產業供應鏈的運行和安全 。
中國光學學會會士、IEEE會士、美國光學學會會士、SPIE會士、IEEE光子學協會全球主席沈平表示 , 中國正處于一個關鍵節點 , 既面臨技術限制 , 也存在創新機遇 , 我們鼓勵與會者將基礎研究與應用相結合 , 以提升中國的能力 。 他希望來自國內外的科學家、工程師和青年學生在這兩天里加強合作 。 深圳作為中國改革開放的重要城市和國家創新型城市 , 提供了理想的背景 。
深芯盟相關領導表示 , 光刻技術作為半導體與集成電路制造的核心環節 , 貫穿芯片設計驗證、前道制造到后道封測的全流程 , 是推動產業從中低端向高端領域躍升的關鍵 , 支撐其精度、效率和工藝水平直接決定芯片的制程節點、功能、性能和良率水平 。 每一次光刻技術的升級迭代 , 都推動著半導體產業向更小、更快、更強邁進 。 光刻技術不僅是微電子制造的關鍵核心 , 更是衡量一個國家高端制造能力和科技自主創新能力的重要標志 。 當前 , 全球半導體產業正在經歷在重構中找機遇、在變革中謀突破的關鍵階段 , 中國已成為光刻技術與設備的重要市場和創新基地 , 特別是深圳依托龐大的終端應用市場、完善的產業鏈配套和開放的國際合作環境 , 在材料、部件、設備等環節不斷拓展國際合作空間 , 逐步形成需求牽引、應用驅動、產業協同的發展路徑 , 正持續為全球光刻技術發展提供豐富的場景支撐與強勁的市場動力 , 助力我國乃至全球光刻技術迭代突破與產業鏈韌性提升 。
中國科學院大學教授、中國科學院微電子研究所研究員、SPIE會士、中國光學學會會士韋亞一主持開幕式 , 并匯報了這幾年IWAPS的發展情況 。 他表示 , 在瞬息萬變且日益復雜的全球環境中 , 學術交流對技術創新至關重要 。 我們的核心目標是搭建一個高效平臺 , 精準鏈接產業界與學術界 , 共同賦能技術進步與產業發展 。 自首屆IWAPS以來 ,IWAPS報告數量和參會者都在不斷增長 。
01共話光刻難題解法
光刻技術是半導體制造的核心工藝 , 它決定了芯片的集成度和性能 。 在芯片制造業的浩瀚宇宙中 , 光刻技術無疑是最為璀璨的星辰之一 , 引領著整個行業的創新與前沿發展 。
在研討會上 , 來自國內外光刻技術領域的專家學者將依次登臺 , 分享各自在各個前沿課題上取得的新突破 , 展示學術成果 , 公布技術開發成果和產品 。
D2S的龐琳勇博士:全芯片曲線光刻技術——推進技術節點(含成熟節點)量產的關鍵 , 及對深紫外光刻的要求 。
反演光刻技術(Inverse LithographyTechnology , ILT)長期以來被認為具有提升先進節點圖案保真度和工藝窗口的潛力 。 然而 , 由于歷史性的運行時間限制、分區邊界問題以及掩模制造問題 , ILT一直被局限于熱點優化應用 。
2019年 , D2S 發布了其基于GPU加速的全芯片無拼接ILT解決方案 , 以應對ILT面臨的挑戰 。 近年來 , 隨著多電子束掩模寫入設備在成熟節點得到了采用 , D2S的TrueMask ILT憑借其速度和操作簡便性 , 已成為光學鄰近效應校正(OPC)的強大替代方案 , 即使是對于成熟節點亦是如此 。
ILT已不再是一種局限于特定領域的技術 , 而是一種掩模制造與晶圓生產上均屬可用的全芯片解決方案 , 在運算速度、操作簡便性乃至掩模制造方面均優于傳統的OPC 。 借助圍繞新穎的SIMD計算框架構建的無拼接、GPU加速架構 , 全芯片曲線ILT在特定情況下甚至比傳統0PC更快 , 并能在掩保真度和晶圓印刷結果上帶來更優的表現 。
【光刻國際頂會,700余位業內人士齊聚深圳】面向整個掩模的曲線掩模制造技術現已在商業掩模廠中準備就緒 。 它在晶圓廠中 , 無需額外的基礎設施變更(既不需要極紫外光刻(EUV) , 也不需要更換光刻機或其他設備) , 并與所有技術節點(從傳統節點到使用深紫外光刻(DUV)的最先進節點)兼容 。 此外 , 在諸多光刻增強技術中 , 采用ILT所需的資本投入最低 , 同時能實現半節點至整節點的性能提升 。
復旦大學教授伍強:大規模工藝、設備及材料開發時期的DICO 。
隨著集成電路制造技術節點逐步邁入5納米及以下階段 , 行業內多數觀點認為 , EUV(極紫外)光工具、光阻材料、光掩模以及 EDA(電子設計自動化)工具已成為該階段發展的必要核心要素 。
在伍強博士看來 , 未來EUV技術相關領域將主要朝著兩大方向推進:第一個方向是依托 DUV(深紫外)技術 , 開展先進 DUV 技術節點的研發工作;第二個方向則是重點布局并發展 EUV 相關基礎設施 , 填補當前在該領域的短板 。
在技術工具層面 , 伍強博士重點介紹了 DICO(設計基礎設施協同優化)工具體系 , 包含純物理光刻建模軟件CF Litho、光源-掩模協同優化軟件CF SMO、像差補償工具CF Flexpupil(類似Flexwave計算) 。
伍強博士進一步指出 , 當前全球半導體行業正積極推進 EUV 技術與 HiNA EUV 技術的路線圖研發 , 而 DICO 工具經過多年實踐 , 已在全球范圍內得到廣泛應用 , 并成為實現新技術高效開發的關鍵支撐手段 。 從實際作用來看 , DICO 工具能夠在設備、材料、生產工藝尚未完全成熟的早期階段介入 , 一方面可以顯著加速新技術從研發到落地的進程 , 縮短技術轉化周期;另一方面 , 還能為設計工程師、工藝工程師、設備工程師及材料工程師提供實踐培訓的機會 , 幫助相關人員積累技術經驗 , 這對于半導體技術的長期持續發展具有重要的建設性意義 。
除此之外 , DICO 工具還具備另一重要價值 —— 能夠幫助彌合曝光工具在 OPE(光學鄰近效應)中的匹配差距 , 進一步提升光刻工藝的穩定性與一致性 。 值得注意的是 , CF Litho 與 CF SMO 兩款核心軟件所依賴的物理光刻模型 , 其有效性與準確性已通過大量生產數據驗證 , 同時在先進光刻膠配方的開發過程中 , 也進一步證實了該模型的可靠性 。
伍強博士還強調 , 上述關于 DICO 工具及相關物理光刻模型的研究成果 , 有望為193納米先進工藝的優化升級 , 以及 EUV 基礎設施的建設與完善提供有力支持 , 推動半導體行業相關技術領域的突破與發展 。
ASML深紫外光刻成像部門專家Jette van den Broeke:面向浸沒式深紫外光刻分辨率極限的光刻技術 。
為了擴展浸沒式深紫外光刻(ArFi)的圖形化技術路線圖并降低制造成本(例如 , 避免使用四重成像技術) , 芯片制造商正在嘗試曝光Pitch低于76nm的圖形:他們正在逼近深紫外光刻(DUV)的分辨率極限 。
這些極端應用場景可能引發多種問題 , 包括產能下降和光刻膠內部性能劣化 。 為確保可靠的量產可行性 , 同時滿足在成像、套刻精度和產能等所有不同方面的性能需求 , 應將光源-掩模聯合優化(SMO)視為關鍵的解決方案 。
Jette van den Broeke在演講中表示 , 為實現近分辨率極限節距的最優光刻效果 , 光線應聚焦在光瞳邊緣的葉形區域內 。 采用這類極端光瞳設計時 , 計量標記的可印刷性與透鏡加熱問題會變得更具挑戰性 , 解決方案可通過光瞳優化來實現 。 值得注意的是 , 提高偏振填充比(PFR)能夠緩解上述問題 , 但是需以降低產品圖形對比度為代價 。 當偏振填充比越高 , 透鏡局部加熱程度越低 , 計量標記對殘余像差的敏感度也越低 。 因此 , 在實際應用中 , 需根據具體應用場景進行針對性優化 , 并匹配相應的光刻層工藝設置 。
西門子MPC產品總監Ingo Bork:在光掩模上繪制曲線圖形的實用解決方案 。
得益于對晶圓成像質量的提升作用 , 曲線掩模圖形的應用正日益廣泛 。 這一趨勢既體現在先進工藝節點中 , 也適用于成熟工藝節點 , 其中在成熟節點場景下 , 曲線圖形能夠拓展DUV光刻機的可用范圍 。
在邏輯芯片與存儲芯片領域 , 曲線形狀對晶圓光刻具有顯著優勢 , 包括擴大工藝窗口 , 憑借光學鄰近校正(OPC)具備更多自由度 , 從而拓寬工藝窗口;提升掩模均勻性 , 且有望改善晶圓均勻性;提高OPC模型精度 , 曲線形狀能更真實地還原掩模圖形 , 進而提升模型準確性 。
然而 , 曲線掩模在應用中也面臨諸多挑戰 , 例如關鍵尺寸(CD)計量難度、掩模規則檢查(MRC)的規則定義復雜度、掩模工藝校正(MPC)的校正質量與運行時長問題 。 若使用可變形狀束寫入器 , 則會面臨掩模寫入相關的技術挑戰 。
鑒于采用可變圖形束寫入器繪制曲線圖形時 , 必需的“曼哈頓化”處理及格式轉換過程 , 可能對邊緣放置誤差和掩模工藝窗口產生不利影響 , 因此Ingo Bork重點關注了此類曲線圖形的繪制問題 。
Ingo Bork分享了在可變形狀束寫入器上繪制曲線形狀的最佳實踐 , 在曲線域內定義并檢查MRC規則 , 然后對CL掩模形狀應用掩模工藝校正 , 該方法技術成熟 , 已在生產中驗證多年 。 在掩模數據準備(MDP)的分割(Fracture)階段轉換為可變形狀束射束 , 并采用基于模型的驗證方式 。
非重疊的可變形狀束(VSB)射束可實現更均勻的劑量分布;當與用戶指定劑量配合使用時 , 能夠在沉積總劑量與邊緣斜率之間達到最佳平衡 。
KLA公司的產品營銷總監Kevin Huang:應對IC制造和封裝挑戰的套刻量測解決方案 。
他指出 , 隨著半導體技術節點持續縮小及3D堆疊等先進封裝技術的興起 , 行業對套刻精度(Overlay)控制提出了前所未有的嚴苛要求 。
KLA的“從設計到控制”全流程的解決方案始于利用模擬器進行優化的“靶標設計”(Target Design) , 隨后進入光刻機的工藝優化環節 , 并通過顯影后(ADI)和刻蝕后(AEI)兩個關鍵節點的量測進行監控 。 整個流程的核心是一個閉環反饋系統 , 通過“批間控制”(R2R Controller)和非零偏置(NZO)校正 , 持續優化光刻機的參數設置 。
報告重點闡述了KLA在套刻量測領域的三大核心技術支柱 。 首先是 “基于圖像的套刻量測”(IBO) , 通過升級光源、對焦系統和相機等硬件 , 并采用 sAIM等更先進的靶標設計 , 滿足前沿技術節點的需求 。 其次是 “基于散射法的套刻量測”(SCOL) , 憑借其超連續譜激光、超快調諧器等技術 , 實現了快速、準確且穩健的套刻控制 。 最后是 “基于掃描電子顯微鏡的套刻量測”(SEM-OVL) , 它利用深度學習等人工智能技術 , 在提供最高精度的同時 , 將檢測速度提升了1.5至2倍 , 并用于校準和優化IBO與SCOL的量測方案 。
勝科納米表面分析部總監朱磊分享了光刻膠和光掩模缺陷失效分析技術的應用 。 失效分析是半導體制造中識別材料或結構失效根本原因的核心環節 。 對于光刻工藝 , 其目標是確保圖形轉移的精確與穩定 。 他指出 , 通過綜合運用物理與化學表征手段 , 可以有效診斷光刻膠和光掩模在生產過程中出現的各類缺陷 。
朱磊首先介紹了光刻膠的失效分析 。 他表示 , 針對光刻膠工藝中常見的污染、化學變化及清洗后殘留等問題 , 需依賴一系列高靈敏度的化學與表面分析技術 。 報告通過案例展示了如何運用傅里葉變換紅外光譜(FTIR)追溯污染物來源 , 利用X射線光電子能譜(XPS)研究材料界面化學態 , 并通過飛行時間二次離子質譜(TOF-SIMS)等手段 , 實現對工藝后痕量有機殘留的精準探測 。
隨后 , 朱磊介紹了光掩模的缺陷分析 。 他指出 , 光掩模的缺陷可能源于設計、材料或刻蝕等多個環節 。 對此 , 先進電子顯微鏡技術是進行物理表征與失效分析的核心工具 。 報告強調 , 通過低電壓高分辨率掃描電子顯微鏡(SEM)等設備 , 可以有效克服掩模材料導電性差所帶來的成像困難 , 從而獲取清晰的圖形輪廓 。 而聚焦離子束(FIB)與透射電子顯微鏡(TEM)的聯用 , 則是在納米尺度下對掩模結構進行截面分析、表征外來物缺陷、以及評估關鍵尺寸、側壁角度等核心工藝參數不可或缺的手段 。
想要獲取半導體產業的前沿洞見、技術速遞、趨勢解析 , 關注我們!
推薦閱讀
- EUV光刻機背后,有一家隱形冠軍,ASML都只能依賴它
- 中國大陸又成為ASML最大買家,買走了42%的光刻機?
- 大模型追逐星辰大海,GPT和Gemini國際天文奧賽奪金
- 三五條樣本擊敗英偉達,國內首個超少樣本具身模型,還斬獲頂會冠軍
- 中美芯戰全面升級,一邊卡稀土,一邊卡光刻機,臺積電遭“夾擊”
- 沒有光刻機!新凱來旗下萬里眼發布90GHz國產示波器 性能提升500%
- 光刻膠,需求旺盛
- 美國著急了:中國拿落后的ASML光刻機,制造出先進芯片了
- 攤牌了?ASML公司光刻機停止出口后,荷蘭出手“接管”中企了?
- 中國的稀土,為何能影響ASML光刻機,能卡住全球的芯片產業脖子?















