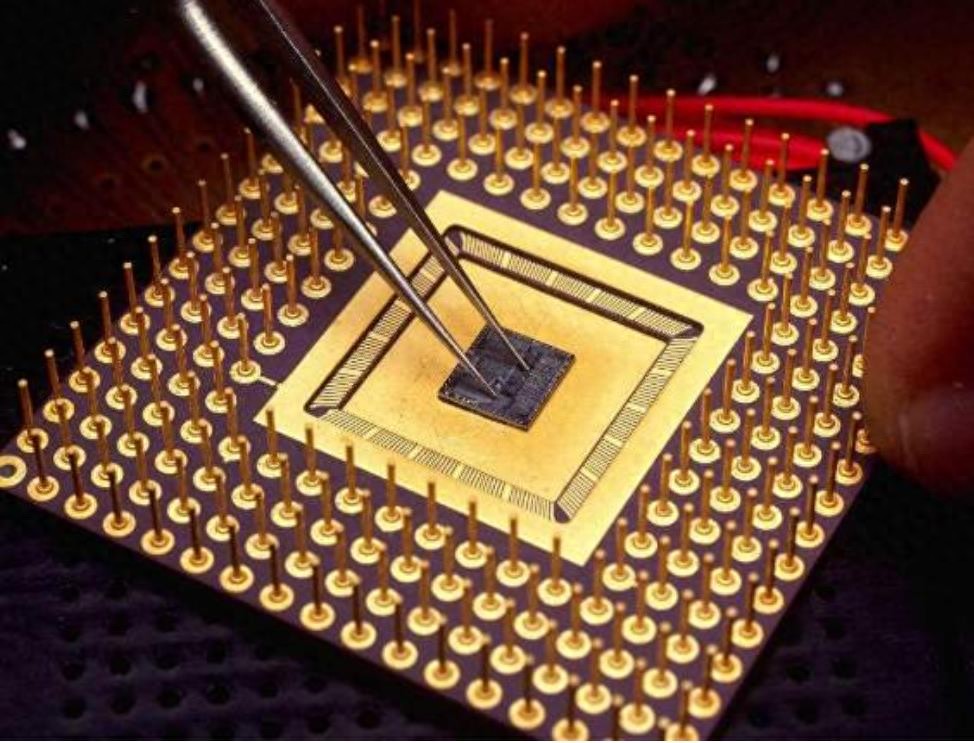
文章圖片
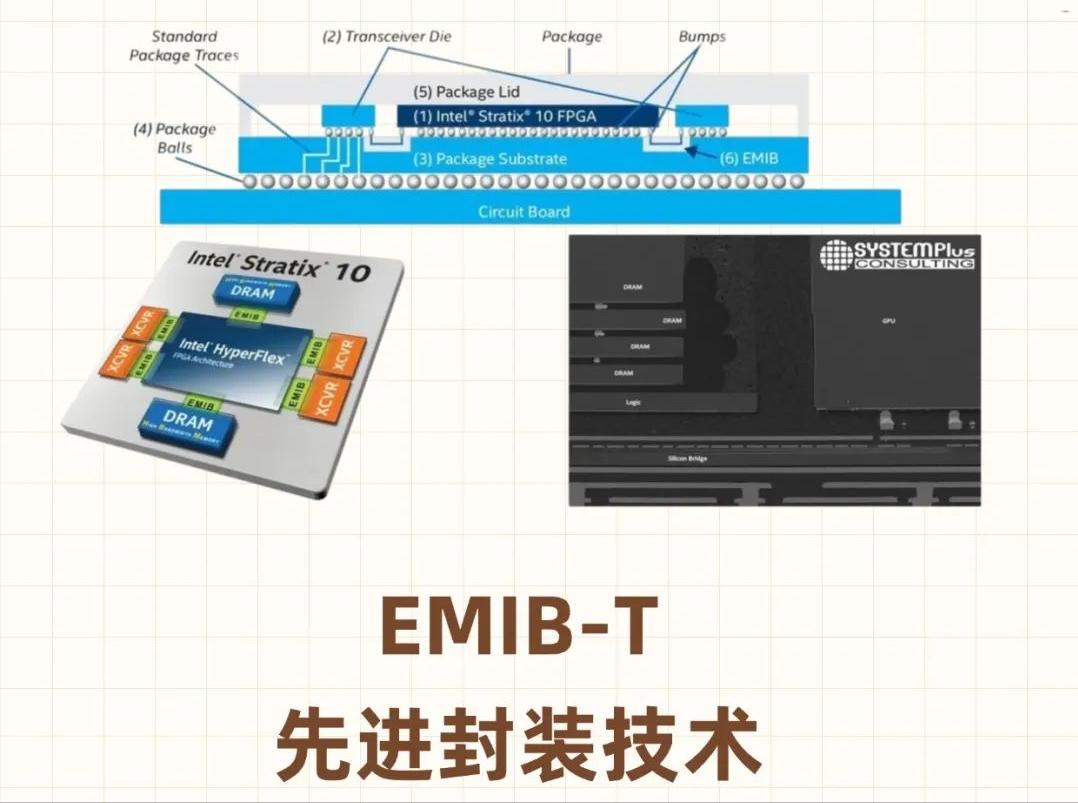
文章圖片
在芯片的全套生產環節中 , 主要分為設計、制造、封測這么三個重要環節 。
當然相對而言 , 芯片設計、制造這兩項是門檻高一點 , 附加價值也會高一點 , 而芯片封測在大家的心目中 , 是附加值最低的一個環節 , 也是門檻最低 , 難度最小的環節 。
再加上前10大芯片封測企業中 , 中國其實有4大企業上榜 , 并且分別位列全球第3、4、6、7名 , 合計份額接近30% , 所以很多人有一個觀點 , 那就是中國芯片封測水平 , 其實是全球頂尖的 , 并不落后 。
但是近日 , 中國工程院院士孫凝暉指出 , 我國先進封裝技術落后國際 2-6 年 。
這句話一說出來 , 很多人不相信 , 覺得這位院士是不是不了解實情 , 在亂說了 。 畢竟目前國內的芯片封測企業 , 其實已經能夠封測3nm芯片 , 似乎和國際頂尖的芯片制造水平是一致的 , 連高通、英特爾、AMD等企業的芯片 , 都交給中國封測企業封測 , 怎么會落后這么多呢?
事實上 , 實際情況還真的就是如此 。
先進的芯片封裝技術 , 并不是指你能封測3nm或2nm芯片 , 真正的難點并不是以XX納米來計算的 , 而是一些封裝的技術 。
比如臺積電的CoWos、CoPoS封裝 , 以及英特爾的 EMIB-T , 從行業來看 , 目前整個封裝是從2.5D過渡到3D的 , 這些封裝技術在復雜的芯片中 , 運用越來越多的 。
比如英偉達的AI芯片 , 全部使用臺積電的CoWos封裝技術 , 而中國封測企業就沒有這個技術 。
從整個市場來看 , 國內封裝市場聚焦的都是一些相對低端的封裝上 , 在AI芯片、HPC、HBM等封裝上面 , 差距是很明顯的 。
雖然這些年來 , 中國封測企業在技術、份額上不斷突破 , 但要縮小與全球頂尖水平的差距 , 還要在技術研發、設備突破、材料創新等方面發力才行的 。
很明顯 , 芯片封測水平如何 , 并不是僅僅將2nm或3nm的裸芯片 , 加上外殼 , 引腳這么簡單就能夠證明你行不行的 。
目前摩爾定律在慢慢失效 , 越來越多的芯片 , 已經走向了立體結構 , 以及將多顆芯片封裝到一起 , 比如HBM、CPU、GPU、NPU等芯片封裝到一起的多功能芯片 。
而這種復雜的、多結構的、以及立體結構的芯片 , 最后的難點就是各種先進封裝技術 。
【被低估的芯片封裝:院士稱我們落后國際,可能2-6年】所以大家別低估了芯片封裝這一塊 , 別以為我們只在芯片制造上落后于全球頂尖水平 , 事實上在封裝上也是有差距的 , 還有很大的提升空間 。
推薦閱讀
- 一加Ace5銷量破紀錄,激活量破200萬,真成中端線的“扛把子”?
- 華為重回第一,vivo壓力山大,iQOO Neo10降價,現在還是比較香的
- 我把 Mac mini 托管到機房了:一套打敗云服務器的終極方案
- 2025國補后,可以“閉眼入”的5款手機,幾乎“零差評”
- 真我Neo7Turbo:性能+續航的完美平衡!
- 近期好價,小米14的16+512GB版,跌至2633元!
- 軟件的公測版和beta版有什么區別?
- 首銷破三萬臺,「賣爆」的小米眼鏡給行業帶來了什么?
- 三大EDA巨頭倒戈 老美被迫自拆鐵墻
- 媒體專訪Anker高管:問題電芯的款式可能生產了2000~3000萬片














