
文章圖片
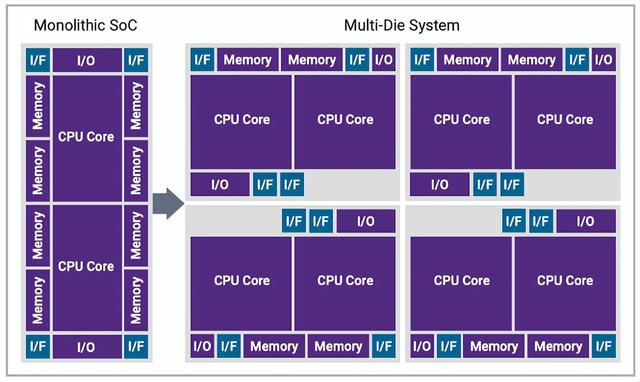
文章圖片
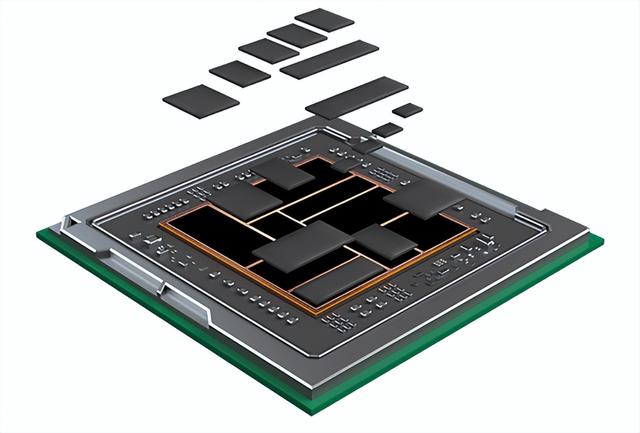
文章圖片
AI推動單片SoC專向多芯片 。
先進封裝正在成為高端手機市場的關鍵差異化因素 , 與片上系統相比 , 它能夠實現更高的性能、更大的靈活性和更快的上市時間 。
單片 SoC 憑借其外形尺寸、成熟的經驗和較低的成本 , 很可能仍將是中低端移動設備的首選技術 。 但多芯片組件提供了更大的靈活性 , 這對于 AI 推理以及跟上 AI 模型和通信標準的快速變化至關重要 。 最終 , OEM 廠商和芯片制造商必須確定如何在設計周期內適應變化 , 以及瞄準哪些細分市場 。
新思科技移動、汽車和消費 IP 產品管理執行總監兼 MIPI 聯盟主席 Hezi Saar 表示:“不受手機制造商束縛的 SoC 供應商必須追求具有 AI 功能的物聯網 SoC 低端功能 , 而這款產品肯定是單片的 。 如果他們需要進軍移動領域的中端市場 , 那么其功能將比物聯網更高 。 它也可能是單片SoC , 并可能通過多芯片技術進行擴展 。 當你走向高端時 , 很明顯你不能只采用單片技術 。 你需要具備制造多芯片的能力 , 以適應即將發生的變化和快速的上市時間 , 因為這才是他們真正賺錢的地方 。 ”
換句話說 , 目標市場決定了架構 。 “我們看到多芯片 3D 技術大勢所趨 , 移動領域也在采用這種技術 , 但其發展速度比 NVIDIA 或 AMD 的 HPC 芯片要慢得多 , 后者在 3D 和 2.5D 技術上投入巨大 , 系統上多達 12 個芯片 , ”Ansys 產品營銷總監 Marc Swinnen 表示 。 “低端移動設備無法做到這一點 。 這主要是成本問題 。 他們必須專注于將盡可能多的功能集成到小尺寸的單芯片中 , 并實現低功耗和高速度 。 ”
據英飛凌稱 , 單片 SoC 包含在單個硅片上運行系統所需的所有組件 , 可能包括具有一個或多個處理器內核的嵌入式微控制器;內存系統 , 如 RAM 或 ROM;外部接口 , 如電纜端口(USB、HDMI);無線通信(WiFi、藍牙);圖形處理單元(GPU);以及其他組件 , 如模擬 / 數字轉換器、電壓調節器和內部接口總線 。
盡管體積小巧(通常也正因如此) , 單片 SoC 卻極其高效 , 其單處理器性能通常優于更復雜的系統 。 信號傳輸距離短 , 驅動這些信號所需的功率更低 , 而且只需一個簡單的散熱器即可散熱 。 許多物聯網 SoC 供應商都采用單片策略 , 因為這可以為客戶節省封裝和集成成本 。
Synaptics 低功耗邊緣 AI 高級產品經理 Ananda Roy 表示:“雖然我們很難做到 , 但把所有功能都放在一個芯片上總是更好的 。 這為我們帶來了競爭優勢 , 因為我們的一些物聯網競爭對手把兩個芯片放在一個封裝中 , 堆疊起來 , 或者并排放置 , 并稱之為單芯片解決方案 。 但實際上 , 它們只是一個封裝中的兩個不同的芯片 。 我們有意識地嘗試轉向單芯片解決方案 , 因為從客戶的角度來看 , 它更容易集成 , 也更容易融入他們的硬件系統設計中 。 我們基本上在單個芯片上構建了多種技術 。 ”
圖 1:嵌入式物聯網 SoC 。 來源:Synaptics
在高端移動市場 , 情況則截然不同 。 該市場使用多個芯片組來提升性能 , 并使用更多互連來降低電阻和電容 。 Cadence 計算解決方案事業部高級產品總監 Mick Posner 表示:“在這種情況下 , 計算引擎通過高性能水平芯片間接口和先進的封裝技術進行‘鏡像’和連接 , 以擴展計算處理能力 。 從技術上講 , 這可以擴展到在 3D-IC 堆棧中垂直擴展芯片的處理能力 , 從而實現更高的互連帶寬 。 ”
多芯片組件還能實現計算單元的更大多樣性 , 包括 CPU 和 GPU 的組合 , 以及高度專業化的加速器 。 Posner 表示:“3D 堆疊并不局限于相同的處理單元 。 AI 或內存加速器單元可以成為堆疊的一部分 , 從而創建高效的特定領域應用引擎 。 利用先進的 3.5D 封裝 , 還可以使用更傳統的芯片間互連(例如 UCIe)水平連接另一個芯片 。 其他芯片無需與處理節點位于同一技術節點 。 各種節點的集成可以在性能和成本之間進行權衡 , 同時選擇最適合應用功能或供應鏈彈性的節點 。 ”
在千禧年的最初幾十年里 , 移動市場推動了許多尖端技術的發展 。 然而 , 隨著 finFET 時代平面微縮優勢的減弱、SRAM 無法微縮以及云端對海量計算能力的需求不斷增長 , 系統公司從單片 SoC 轉向了 2.5D 系統 , 通過中介層連接多個芯片 。 雖然移動市場在工藝微縮方面仍處于領先地位 , 但高端移動市場已經超越了這一水平 , 擴展到多芯片組裝 —— 盡管目前尚不清楚移動設備是否會采用 3D-IC , 因為它們需要某種先進的冷卻系統 , 而這在當今的移動設備中并不實用 。
Synopsys 的 Saar 表示:“2.5D 速度非常快 , 效率極高 , 而且距離極短 , 因此功耗非常高 。 這些芯片可以采用不同的工藝制造 。 這個芯片可以是 2nm(基礎芯片) , 而 AI 加速器可以是其他芯片 。 它們非常靈活 。 ”
圖 2:單片 SoC 與多芯片 SoC 。 來源:Synopsys
高端移動設備正在向 2nm 全柵 (GAA) 制造工藝邁進 , 以實現高性能 , 但這種工藝成本高昂且生產時間冗長 。 Saar 表示:“GAA 工藝需要 X 個月才能從晶圓廠返回 。 你需要壓縮所有這些時間 , 這是最大的挑戰 。 你正在流片的東西在過去是值得量產的 。 這一次 , 你知道你至少需要再進行一次流片 , 而且在你進行流片的同時 , 規格可能還會再次演變 。 我原先認為我需要 70 億個參數 。 現在我需要 140 億個參數 , 因為手機的用例已經發生了變化 。 未來我不知道會是什么樣子 , 但他們在引入這些功能時需要考慮到這一點 。 這就是為什么多裸片似乎是解決靈活性、不確定性和規格持續演變以及你必須采取的市場風險緩解措施的正確答案 。 ”
Saar 指出 , 每家手機廠商都可以根據其想要占領的市場數量來決定如何部署 AI 。 “你可以集成一個 AI 加速器 , 也可以把它放在單獨的芯片里 , 也可以是專用芯片 , 甚至可能是幾個專用的 AI 加速器 。 這取決于你想要的性能 。 假設我想要一個用于功能手機的基礎芯片 。 我添加了一個 AI 加速器芯片 , 這相當于兩者之間的 3D 連接 。 現在 , 我又在芯片側面添加了一個芯片 , 比如說 , 用于 I/O 擴展 , 因為我想進軍多媒體市場 。 現在我需要更多的顯示功能 。 我需要 EDP(電子數據處理) 。 SoC 廠商可以將基礎芯片(獨立的、單片的)賣給功能手機市場 。 他們可以添加加速器 。 現在它變成了智能手機配置 , 他們可以在芯片側面添加另一個芯片 。 然后 , 它就變成了消費設備、超級機器人或 PC , 他們可以運用所有這些配置 , 從而進軍不同的市場 。 ”
通過將 AI 加速器放在第二個芯片上 , 供應商可以獲得更好的性能 , 因為它在仍然使用相同基礎的同時進行了優化 。 “現在 , 它不再需要花費數億美元反復旋轉硅片 , 而是更加穩定了 , ”Saar 說 。
采用多芯片的另一個原因是考慮到模擬和數字信號 。 例如 , Synaptics 用于可折疊移動 OLED 顯示屏的觸摸控制器可以區分握持設備、口袋撥號、水滴或汗水等情況 。 “我們的芯片包含一個模擬芯片和一個數字芯片 , 模擬芯片直接連接到傳感器 , 數字芯片處理所有這些信息 , ”Synaptics 產品營銷總監 Sam Toba 表示 。 “在數字芯片內部 , 我們有一個 MCU 內核 , 之前我們有一個內部定制的 MCU 內核 , 這確實有很多優勢 。 但是一旦涉及到這些可折疊設備 , 需要處理的信息量就會變得非常非常大 , 因此我們決定采用 RISC-V 。 Si-Five 的 E7 是一個非常強大的 MCU 內核 , 非常適合高水平處理 , 我們的矢量協處理器就位于它的外部 。 ”
然后 , AI/ML 算法可以判斷環境并檢測真實的手指觸摸 。 “我們的芯片連接到觸摸傳感器 , 檢測所有信號 , 將模擬信號輸入模擬芯片 , 然后在數字芯片上進行處理 , ”Toba 說道 。 “該數字芯片包含 E7、Hydra、所有算法和內存 。 一旦芯片確定觸摸是有意義的、有意的 , 它就會向主機 SoC 報告 。 ”
內存和通信的復雜性與人工智能一樣 , 內存也在不斷變化 , 并且會隨著不同的市場而變化 。 Saar 表示 , 如果一家 SoC 供應商瞄準所有市場 , 他們有幾種方法可以實現 。 “他們可以做單片芯片 。 但是 , 他們如何適應硅片的多次自旋?他們現在有 LPDDR 6 , 它已經定義好了 , 但它會繼續發展 。 UFS 5.0 現在已經定義好了 , 但它會繼續發展 。 那么 , 他們會再自旋一次 2nm 硅片嗎?還是會將其限制在其他方面?”
還有各種各樣的網絡需要考慮 。 手機芯片需要足夠靈活 , 才能支持新的 5G/6G 協議 , 同時繼續支持舊技術 。 “在單個系統中支持額外的帶寬會增加數據處理的復雜性 , 也意味著大量的功耗 , 所以你必須非常高效地實現它 , ” 弗勞恩霍夫 IIS/EAS 高效電子部門負責人 Andy Heinig 表示 。 “否則 , 一方面 , 移動設備會在很短的時間內耗盡電池電量 。 另一方面 , 你還必須散熱 。 你有這些多物理場要求 , 你需要非常高效的加速器、非常高效的 DSP 實現、數據處理等等 。 這就是為什么每個人都越來越多地談論專用處理器的原因 。 ”
在前沿設計中 , 這在很大程度上涉及芯片集和異構集成 。 在智能手機的模擬 / 混合信號領域 , 這可以幫助抵消多芯片組件帶來的部分額外成本 。 根據 Cadence 的白皮書 , 這種方法可以 “靈活地為 IP 選擇最佳工藝節點 —— 尤其是對于 SerDes I/O、RF 和模擬 IP , 這些 IP 無需位于‘核心’工藝節點上” 。
圖 4:SoC 分解圖 。 來源:Cadence
電源、電池和散熱考慮因素【多芯片3D IC,大勢所趨】在高端移動市場 , 供應商正在競相支持 AI 。 西門子數字工業軟件解決方案網絡專家 Ron Squiers 表示:“iPhone 15 和 16 在板載處理中添加了 AI 硬件 , 許多智能和硬件正在硅片級別融入這些芯片中 。 NVIDIA 等其他公司正在打造 GPU 。 Arm 正在打造 Zen 5 [CPU
, 它充當平臺上 AI 硬件的協調器 。 亞馬遜正在開發他們的 Trainium 訓練和推理芯片 , 因此超大規模計算廠商和移動開發者都在做這件事 。 ”
雖然移動設備始終需要 GPU 進行圖形處理 , 但最新版本的 GPU 也能出色地處理 AI 工作負載 。 例如 , Imagination Technologies 在其 E 系列 GPU 中 , 極大地改變了 ALU 流水線中工作負載的調度和執行方式(見下圖 5) 。
Imagination 技術洞察副總裁 Kristof Beets 表示:“它曾經擁有非常復雜、非常深的流水線 , 流水線級數眾多 , 而且流水線延遲很長 。 我們一直從一個非常大的寄存器存儲器(GPU 中 0.5 MB 大小的 SRAM)中持續提供數據 —— 因此 , 這是一個非常大容量、緊密耦合的大型內存 。 問題是 , 如果你在每個周期都不斷地從中獲取大量數據 , 然后將其推送到這個流水線 , 并且在每個周期都寫出結果 , 那會非常耗電 。 ”
圖 5:突發處理器減少了 GPU 內部的數據移動 。 來源:Imagination
新設計采用了更輕量級的流水線 , 只有兩級流水線 , 并且可以在本地重用更多數據 。 “我們不會不斷訪問龐大的 SRAM , 而是嘗試重用我們附近的已有數據 。 這些數據可以是之前的結果 , 也可以是相鄰流水線中的數據 。 因為如果你觀察很多人工智能案例 , 就會發現你經常會通過一系列處理操作來對數據進行混洗和傳輸 , 并從相鄰的流水線中獲取數據 。 ”
由此帶來的幀 / 秒 / 瓦效率提升可以轉化為更長的手機電池續航時間 。 “這可能會影響運營成本 , 但我們在移動領域可以做的另一件有趣的事情是 , 將額外的功耗節省轉化為更高的時鐘頻率和性能 , 因為我們可以保持相同的功耗和熱預算 , ”Beets 說道 。
無論設計師如何實現更佳性能 , 功耗仍然是一個關鍵問題 。 “如今 , 每個人都對功耗很感興趣 , 甚至連數據中心的人員也不例外 , 但移動設備的傳統業務歷史更為悠久 , 而且它們采用電池供電 , 因此它們在低功耗方面的需求更為突出 , ”Ansys 的 Swinnen 說道 。
除了每日電池續航時間 , 手機制造商還必須考慮電池壽命 。 手機的每個方面都會產生影響 , 包括 SIM 卡 。 為此 , 英飛凌開發了一款微型 28 納米 eSIM 卡 , 其功耗遠低于傳統 SIM 卡 。 eSIM 卡允許用戶輕松切換不同的服務提供商 , 同時由于無需物理訪問 , 制造商在設計方面也更加靈活 。
結論手機供應商根據他們所針對的價格層級以及他們現在或將來想要實現的 AI 功能和通信標準 , 采取不同的芯片設計方法 。
Synopsys 的 Saar 指出 , 設計決策通常歸結于商業原因 。 “這就像你問為什么一個特定的標準會流行起來 , 而不是一個技術上可能更優越的標準 。 原因有很多 , 現在這個或那個并不重要 。 如果一家供應商控制著整個垂直產業鏈 , 他們就不必使用標準的現成的虛擬制作 (VP) 攝像頭接口或任何存儲接口 。 他們可以創建自己的接口 , 即使質量較差 。 在他們看來 , 他們可以獲得各種程度的利益 , 也許是更高水平的集成和卓越的運營 。 ”
與此同時 , 許多新進入者正在這個競爭激烈的細分市場中開辟自己的道路 。 “他們過去只做手機 , 現在也做 SoC , ”Saar 說道 。 “對他們來說 , 情況完全不同 。 他們可以進行不同的優化 。 他們不必涉足廣泛領域 , 因為他們只關心自己的手機 。 他們只關心自己的用例 。 有些公司在整個市場 , 而不僅僅是移動市場 , 都擁有 AI 地位 。 我們正在制定超越硬件的企業戰略或全球戰略 。 也許混合戰略對他們來說確實有意義 , 因為我希望手機能夠連接到云端的 AI 引擎 , 因為現在我有了差異化 。 你買我的手機 , 你連接到我的云端 , 你連接到我的電子郵件 。 一般的 SoC 沒有這些 。 他們賣的是硬件 。 ”
*聲明:本文系原作者創作 。 文章內容系其個人觀點 , 我方轉載僅為分享與討論 , 不代表我方贊成或認同 , 如有異議 , 請聯系后臺 。
想要獲取半導體產業的前沿洞見、技術速遞、趨勢解析 , 關注我們!
推薦閱讀
- 外觀到底有多重要!且看OPPO的日月光配色,背后的真相
- 英偉達B200芯片,供不應求
- 阿里開源智能體WebSailor,又刷新了多項紀錄
- M5 自研芯片太貴了,蘋果打算讓全家桶都用上
- 三星Galaxy Z Flip7真機曝光,外屏更大,搭載自研芯片
- 多年研發白白浪費?三星Galaxy Z Fold7疑似取消屏下攝像頭
- 小米16提前1個多月發布!4年前向蘋果學習,今年要硬剛蘋果
- 發布不到2個月,小米玄戒,已拿下安卓手機芯片0.6%的份額
- 小米YU7搭載驍龍8 Gen3芯片穩定性遭質疑,官方回應
- 美國專家:AI開始拼芯片,最終拼能源,這一點中國完勝










