
文章圖片

文章圖片

文章圖片

文章圖片

文章圖片

文章圖片

文章圖片
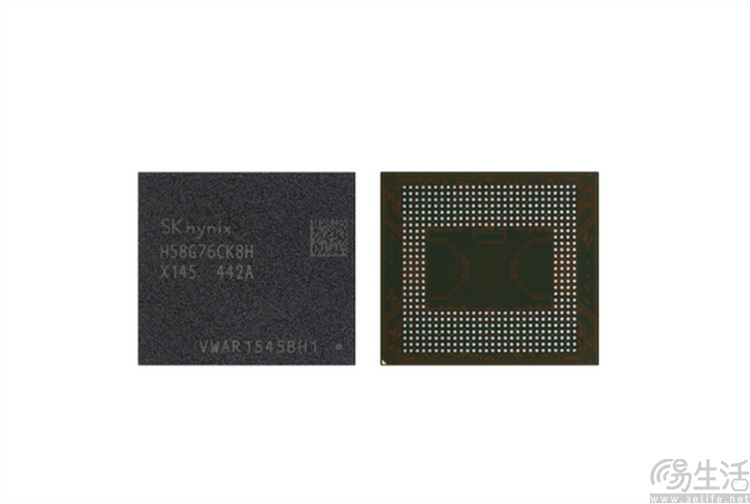
文章圖片

最近這段時間 , 雖然名義上已經進入秋季 , 但仍有動輒30來攝氏度的高溫 , 依然能讓許多人感受到盛夏不愿離去的“熱情” 。
在這樣的環境下 , 熱的不只是我們自己 , 還包括了各種各樣的數碼產品 。 在它們之中 , 與用戶最為“朝夕相處”、且本身對溫度較為敏感 , 發起熱來也更容易被察覺的 , 毫無疑問就是手機了 。
當然 , 如果是玩機經驗相對豐富的朋友可能會感到疑惑 , “手機這東西 , 過去好多年都沒覺得會有多熱 , 為什么這幾年就特別熱起來了呢?”
別說 , 這還真是個問題 。 今天我們三易生活就來簡單探討一下 , 這些年手機到底是怎么“熱起來”的 , 以及手機廠商為了壓制熱量 , 又在散熱設計上做過哪些設計 。
早期智能機也發熱 , 只是很多人沒機會知道
關注我們三易生活的朋友可能還記得 , 我們本就收藏了好些古早的“國產智能手機” 。
以當時的眼光來看 , 這些機型有大尺寸觸屏、有看起來像電腦的操作邏輯 , 有些甚至還有模塊化的攝像頭 , 它們毫無疑問是彼時頂級“精貴”的產品 。 但如果要以當下的標準來衡量 , 那么這些早期智能手機還有一個普遍的優點 , 就是它們幾乎不會讓人感覺到有什么發熱 。
【如何讓手機更“涼快”?智能手機散熱簡史】這是為什么呢 , 難道是因為早期智能手機的性能“不過剩”嗎?顯然不是 。 真正的原因 , 在于這些機型其實嚴格來說 , 都不能叫做“智能手機” 。 它們只是看起來像智能手機 , 操作系統往往并沒有獨立的軟件擴展能力 , 處理器通常也是頻率極低的早期16位CPU , 所以就算是想“發燒”、也真熱不起來 。
那么當時有沒有真的會發熱的手機呢?其實是有的 , 比如諾基亞在1996年推出的初代Communicator(通訊器)系列旗艦型號諾基亞9000 。 它不只開創了側翻蓋+超大內屏這一標志設計 , 而且本質上真的就是一款“能打電話的電腦” 。
因為諾基亞9000采用的就是英特爾的30386EX處理器 , 并運行GEOS v3.0操作系統 , 所以這款當時售價約合人民幣1萬元(1996年的1萬元)的“智能手機鼻祖” , 通話續航時間僅有3小時 。 所以當年就能感受到早期智能手機“熱度”的用戶 , 無疑也稱得上是非富即貴了 。
從里程碑開始 , 智能手機的“熱度”開始普及
當然 , 像諾基亞9000這樣直接用PC處理器的手機還是太少見 , 所以在之后的很長一段時間里 , 盡管市面上開始出現越來越多的塞班、Windows Mobile智能手機 , 但它們畢竟采用的都是低功耗 , 主頻才兩、三百兆赫茲的CPU , 本身也幾乎不可能有被感知到的發熱情況 。
真正開始普遍讓用戶感受到“熱情”的機型 , 要一直等到2010年前后才會出現 。 在那一年 , 谷歌的安卓操作系統已經大有取代諾基亞塞班的勢頭 , 而以三星i9000、摩托羅拉里程碑為代表的最早一代“安卓旗艦” , 差不多就正是在這個時間點上市 。
這里面特別值得一提的 , 就是摩托羅拉的里程碑 。 它一方面使用了一套導熱效果良好的厚實金屬外殼 , 另一方面搭載的德州儀器OMAP3430處理器制程較為落后、但頻率很低(600MHz) , 所以超頻潛力極其巨大(可以輕松達到1GHz甚至1.2GHz) 。
于是在早期安卓社區“折騰為王”的氣氛下 , 售價2000多元的這款機型就讓大量玩家第一次在手機上感受到了什么叫做“熱得拿不住” 。 從某種角度來說 , 這些最早在安卓手機上玩超頻的人 , 或許算得上是真正的“發燒友了” 。
首發1.5GHz雙核處理器的小米2 , 第一次讓“手機散熱”這個概念為大眾所知
有意思的是 , 就是在里程碑之后 , 整個安卓手機陣營后續各家的處理器方案 , 似乎都開始有了“發熱失控”的跡象 。 比如最早的手機雙核處理器Tegra2 , 以及與其同世代的高通MSM8x60系列 , 都要比里程碑那個時期的單核方案熱得多 。 也正是在搭載高通MSM8x60的小米2系列上 , 許多用戶第一次認識到了“石墨烯散熱膜”這個東西 , 并有了“手機還要散熱”的概念 。
驍龍810創下的“火龍”神話 , 改變了這個行業
2013年 , 蘋果在iPhone 5s上首發自研芯片A7 , 這也是業界首款應用64位架構的智能手機處理器 。 它的誕生客觀上打亂了其他所有友商的產品節奏 , 間接導致驍龍810這個知名“火龍”的誕生 。
有看過我們三易生活相關考古內容可能還記得 , 一方面高通在驍龍810之前 , 產品研發其實已經進入了死胡同 。 其末代32位方案驍龍805實際發熱絕不比驍龍810來得低 , 只是因為用的機型少 , 所以許多消費者沒怎么在意 。
另一方面來說 , 當時“犯錯”的廠商不只高通一家 。 比如 , 三星也拿不成熟的20nm制程搭配公版A57+A53方案 , 搞了個同樣又熱又卡、甚至就連64位應用都打不開的Exynos5433(也叫Exynos7410) , 但它同樣是因為搭載機型少見 , 所以才沒有那么大的“惡名” 。
但也正是因為驍龍810客觀上的發熱高 , 就直接催生了智能手機行業在散熱設計上的一次巨大進化 。 正是在驍龍810時代 , 手機廠商第一次將熱管塞進了機身 。 與此同時 , 由于HTC的全金屬機身導致他們在驍龍810時期背了個大鍋 , 也在一定程度上影響到了其他廠商后續對于機身后蓋的材質選擇 。
熱管、均熱板、內置風扇 , 手機散熱進入堆料時代
以如今的“事后眼光”來看 , 驍龍810后續的數代旗艦SoC , 能效比好幾年都呈現出不斷改善的態勢 。 但站在當時廠商們的角度 , 他們顯然不可能“未卜先知” 。
于是差不多從驍龍820時代開始 , 智能手機的散熱設計就成為了各廠商或主動或被迫的“堆料”方向 。
比如在導熱材質上 , 最初各大廠商用的還是單根細細的熱管 。 但很快它就被改成了能給整個SoC , 甚至部分電池和攝像頭區域也進行散熱的VC(Vapor Chamber、即均熱板) 。
接下來就是均熱板的面積越做越大 , 內部毛細結構愈發復雜 , 材質也從純銅進化到了銅+不銹鋼的復合設計 , 甚至還有廠商在上面鍍上真金白銀 , 號稱可以進一步提高熱導率 。
這還沒完 , 因為均熱板再大 , 所起到的作用也只是將較小面積的熱源熱量 , 快速“分布”到一個較大的面積上 。 也就是說 , 均熱板本身只能“導熱”、不能“散熱” , 所以進一步的“主動散熱”技術 , 自然也開始在手機行業中出現 。
在這個方向上 , 首開記錄的自然是紅魔 。 早在2018年 , 當時還在努比亞體系下的紅魔 , 就率先喊出了“風冷散熱”的概念 。 當時他們的做法是在機身內部設計了風道 , 并通過在后蓋上設計散熱口的方式 , 來實現內外部空氣的被動交換 。
當2019年紅魔3帶著首發的內置主動式風冷問世后 , 很快就“啟發”到了更多的游戲手機廠商加入到內置風冷散熱的陣營中 。 比如后來聯想的拯救者也曾嘗試過內置風冷散熱 , 而且一次性還堆了兩個風扇 。
隨著近年來手機電池技術的進步 , 內置風冷這種原本僅限于“硬核游戲手機”的設計 , 似乎有進一步擴散的趨勢 。 比如OPPO前段時間就推出了內置風扇的新機OPPO K13 Tubro系列;真我更是剛剛展示了同時內置風扇和TEC半導體制冷器的概念機 , 在手機散熱“堆料”的道路上再進一步 。
降溫還得回到“源頭” , 全新的芯片散熱技術將至
不難發現 , 從最初“沒人覺得手機還能發熱” , 到如今各家都在爭相推出更極致、更強的手機被動或主動散熱技術 , 智能手機的“發熱”不僅成了行業共識 , 而且似乎有愈演愈烈的趨勢 。
從原理上來說這確實有點無奈 , 一方面 , 摩爾定律擺在那里 , 只要芯片的性能提升幅度超過了制程進步的速度 , 發熱量的增加就是在所難免 。 另一方面 , 隨著如今AI技術、尤其是端側AI在手機上的落地 , SoC日常計算量的大幅上漲已經成為了必然的趨勢 。
一加內置水冷的概念機
那么在這樣的情況下 , 如何才能進一步“壓制”手機SoC的熱量呢?是提高內置風扇的轉速、還是堆更大更厚的VC , 又或者是給手機附加能主動吸熱的保護殼呢?
近日 , 多個上游芯片廠商“不約而同”提出了一個新的設計思路 。 它們直接在芯片本身的“散熱架構”上下手 , 通過改善芯片的導熱效果 , 更快地將內部熱量導出、散逸 , 從而在不改變現有手機內部結構的前提下 , 從源頭降低機身內部SoC的溫度 。
率先做出改變的 , 是內存廠商SK海力士 。 根據他們的說法 , 其成功開發出了行業首款“High-K EMC”移動內存芯片 。 該芯片采用了比一般設計更高導熱率的封裝材料 , 將內存芯片本身的內部垂直熱阻降低了47% 。
要知道對于當下的旗艦手機來說 , 通常都會采用SoC與內存“疊放”的設計 , 即內存芯片直接焊接在SoC頂部 。 這樣的設計主要是為了降低SoC與內存之間的電路長度 , 從而有利于改善內存信號、支持手機跑出驚人的內存頻率(比如動輒8533MHz、9600MHz) 。 但也正因如此 , “蓋”在SoC頂部的內存芯片 , 本身其實就成了一個巨大的熱阻(而且它自己也會發熱) 。 所以SK海力士改善內存芯片內部導熱率的設計 , 顯然是非常有意義的 。
不過僅僅這樣還不夠 , 因為增強內存的導熱性能 , 只是意味著SoC的熱量或許可以更快地傳導到內存芯片表面 , 并不能改善這兩顆芯片進一步向外“散熱”的速度 。
此外有消息稱 , 三星已經在他們自研的Exynos 2600上運用了另一種芯片級的導熱方案 。 其通過半導體制造工藝 , 直接在SoC頂部、沒有被內存芯片覆蓋的區域 , “耦合”了一層與內存芯片同高度的銅質導熱結構 , 并稱之為“HPB(Heat Path Block , 導熱塊)” 。
很顯然 , 金屬材質的HPB導熱塊 , 傳熱速度會比硅+塑料材質的內存芯片要快得多 , 因此有望以更高的效率將SoC表面熱量傳導到機身內部的散熱結構上去 。 當然 , 如果將它與海力士的高導熱內存配合使用 , 效果可能還會更好 。
不過考慮到這項技術大概率是三星拿來秀自家半導體封裝的“炫技”成果 , 所以不太可能馬上就在今年年底的這一輪新機上見到實際效果 。 但如果它確實很有效的話 , 那么最快到明年 , 這種直接將導熱材料與SoC硬連接的設計 , 可能就會成為許多旗艦新機的“標配” 。 至于它是否能真正帶來手機散熱效果的革命性提升 , 就只有時間才能給出答案了 。
【本文圖片來自網絡】
推薦閱讀
- 買新不買舊,RTX50筆記本如何選?4款神機承包學生黨開學裝備
- 上半年全球高端智能手機:華為增長24%,小米增長55%
- 2025國補后,3款最值得買的小尺寸直屏手機,16GB+512GB有真香價
- 從嘗鮮到實用,折疊屏手機“卷”向軟件生態
- 還是LG和三星!iPhone 17 Pro屏幕爆料,網友:讓子彈飛一會兒
- iPhone17Pro國行版被曝“國產屏沒了”:真相卻讓果粉意外!
- 蘋果要在手機上再刪除一個孔
- 8200mAh續航滅霸+軍工級防護,vivo Y500讓你告別電量焦慮!
- 外賣快遞員最愛用什么手機?首選vivo,華為比小米更受歡迎
- 上半年全球折疊屏手機市場:華為份額高達48%,是三星的2.4倍!














